三菱マテリアルは12月5日、ハイブリッド(HV)車の高出力モータ電源制御用インバータなどに向けた次世代パワーモジュール用高性能絶縁回路基板「厚Cu付きDBA基板」を開発したと発表した。
近年、HV車などの電源制御用インバータなどに用いられる絶縁回路基板には、素子の高出力化に伴う発熱密度増大に対応するため、熱伝導率の高い銅を厚板で回路材に用いることにより熱抵抗を低減する仕様が求められている。しかし、高強度のセラミックスである窒化珪素を絶縁基板に用いても、銅回路材の厚さは0.8mm程度が限界で、それを超えて銅回路材を厚くした場合、基板が割れ易くなる課題があり製品化が困難だった。
今回同社が開発した厚Cu付きDBA基板は、セラミックス基板の両面に接合されたアルミニウム板に、銅回路材を直接接合した構造で、従来よりも大幅に肉厚である3.0mm(従来比約4倍)程度の銅回路材接合が可能としている。
また、銅板とセラミックス基板の間に接合した高純度アルミニウム層が熱応力を緩和し、温度サイクル(-40~125度×3000サイクル以上)の条件下においてもセラミックス割れを防止するなど、高い信頼性を実現している。

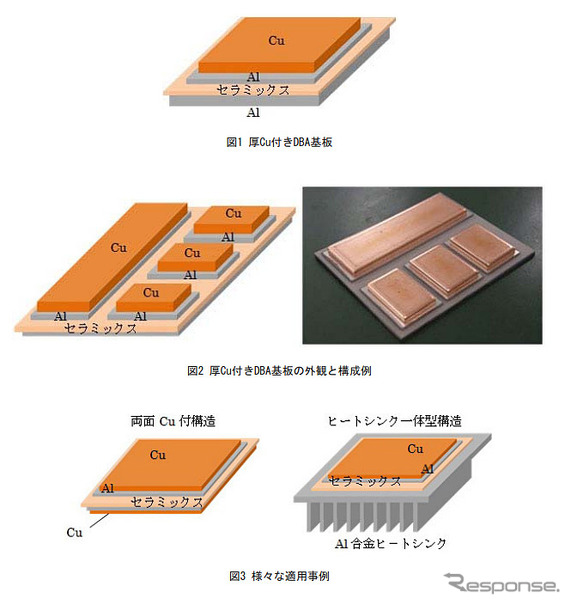
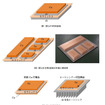
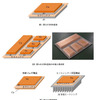


![不祥事企業の株主総会本格化…神鋼、三菱マテ、スバル、日産[新聞ウォッチ]](/imgs/sq_m_l1/1314466.jpg)



